-
日期: 2024-01-06 | 來源: 半導體行業觀察 | 有0人參與評論 | 字體: 小 中 大
搭積木壹樣造芯片。
據不完全統計,目前半導體行業已開發出約 1000 種封裝類型,按互連類型來劃分,其中包括了引線鍵合、倒裝芯片、晶圓級封裝 (WLP) 和硅通孔 (TSV)等,無數個die通過互聯器件相連接,構成了如今日漸繁盛的封裝市場。
其中的先進封裝,成為了近兩年最受關注和歡迎的領域,先進制程進展越緩慢,它的重要性就愈發突出, AMD、英特爾和英偉達這傳統的“御叁家”紛紛涉足,從2D封裝轉戰2.5D封裝,還向3D封裝這座高峰發起了挑戰。
2023年6月,AMD在舊金山正式推出了MI300X與MI300A兩款AI加速器, 其中MI300X 采用了8 XCD,4個IO die,8個HBM3堆棧,高達256MB的AMD Infinity Cache和3.5D封裝的設計,支持 FP8 和稀疏性等新數學格式,是壹款全部面向 AI 和 HPC 工作負載的設計,而它的晶體管也達到了1530 億顆,成為了 AMD 迄今為止制造的最大芯片。
AMD表示,MI300X 在人工智能推理工作負載中的性能比英偉達 H100高出1.6倍,在訓練工作中的性能與 H100相當,從而為業界提供了亟需的高性能替代品,以取代英偉達的GPU。此外,這些加速器的 HBM3 內存容量也是英偉達 GPU 的兩倍多,達到驚人的 192 GB,使其 MI300X 平台能夠支持每個系統兩倍多的 LLM,並能運行比 H100 HGX 更大的模型。
最受矚目的當然還是AMD所宣稱的3.5D封裝,AMD表示,通過引入3D混合鍵合和2.5D的硅中介層,實現了全新的“3.5D封裝”技術。
AMD 高級副總裁兼企業研究員 Sam Naffziger 表示:“這是真正令人驚歎的硅堆棧,提供了業界目前已知的最高密度性能。這壹集成采用了台積電的兩種技術,即 SoIC(集成芯片系統)和 CoWoS(芯片基板芯片)。前者(SoIC)使用混合鍵合技術將較小的芯片堆疊在較大的芯片之上,無需焊料就能直接連接每個芯片上的銅墊,其幫助高速緩沖存儲V-Cache 芯片堆疊在最高端的 CPU 芯片上,而後者(CoWos)將芯片堆疊在壹塊更大的硅片上,這塊硅片被稱為內插板(interposer),用於容納高密度互連。”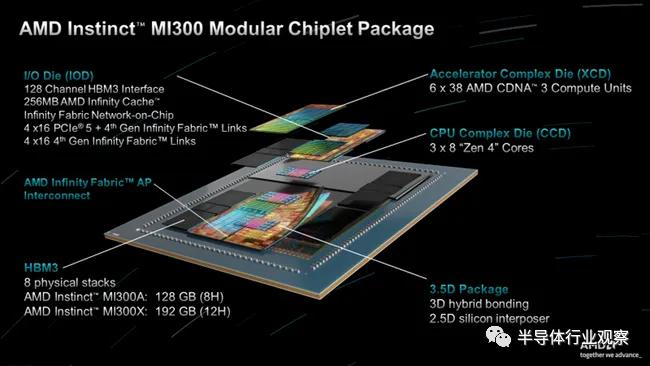
當英偉達還在H200中使用台積電CoWoS的2.5D封裝時,AMD卻率先壹步,實現了台積電SoIC 3D封裝和CoWoS 2.5D封裝的結合,而它更早之前對Chiplet的布局,似乎早已為這次彎道超車做足了准備。
搭積木壹樣造芯片
首先我們來回顧壹下MI300X和MI300A的具體架構,根據AMD官方的解釋,MI300系列采用了台積電的 3D 混合鍵合 SoIC(集成電路上硅)技術,在肆個底層 I/O 芯片之上對各種計算元件進行 3D 堆疊,無論是 CPU CCD(核心計算芯片)還是 GPU XCD。每個 I/O 芯片可以容納兩個 XCD 或叁個 CCD。每個 CCD 與現有 EPYC 芯片中使用的 CCD 相同,每個 CCD 擁有八個超線程 Zen 4 核心。MI300A 使用了其中的叁個 CCD 和六個 XCD,而 MI300X 使用了八個 XCD。
所謂 XCD,是AMD在GPU中負責計算的Chiplet,在MI 300X上,8個XCD包含了304 個CDNA 3 計算單元,那就意味著每個計算單元包含了34個CU。作為對比,AMD MI 250X 擁有220個CU,這是壹個較大的飛躍。
而HBM 堆棧則采用了 2.5D 封裝技術的標准中介層進行連接,每個 I/O 芯片都包含壹個 32 通道 HBM3 內存控制器,用於托管 8 個 HBM 堆棧中的兩個,從而為該設備提供了總共 128 個 16 位內存通道。MI300X 采用 12Hi HBM3 堆棧,容量為 192GB,而 MI300A 使用 8Hi 堆棧,容量為 128GB。
具體而言,AMD 的 CPU CCD 通過 3D 混合鍵合到底層 I/O 芯片,通過利用標准 2.5D 封裝的GMI3接口進行通信,AMD 為此添加了壹個新的焊盤通孔接口,可繞過 GMI3 鏈路,從而提供垂直堆疊芯片所需的 TSV。- 新聞來源於其它媒體,內容不代表本站立場!
-
原文鏈接
原文鏈接:
目前還沒有人發表評論, 大家都在期待您的高見